[반도체 공정 및 장비] Ion Implantation (이온주입, Doping)

https://piscesue0317.tistory.com/67
[반도체 공정 및 장비] Diffusion (확산, Doping)
반도체를 만드는 데에 있어서 Doping은 필수적인데요, 이러한 Doping 과정이 필요한 이유와 Doping 방법론들에 대하여 알아보겠습니다. Doping 먼저 Doping이란 의도적으로 반도체에 불순물을 첨가함으
piscesue0317.tistory.com
지난 글에서는 Doping 방법 중 확산에 대해서만 알아봤는데요,
위 글에 Doping에 대한 정의와 관련 이론들이 함께 있으니 한 번 살펴보시면 좋을 것 같습니다 !
Ion Implantation
Ion Implantation(이온주입)이란 웨이퍼 표면에 이온상태의 불순물을 주입하는 것으로
보다 정확한 양의 불순물을 원하는 곳에 Doping하는 것이 목표입니다.
즉, 이를 통해 조금 더 넓은 범위에서 불순물의 양을 제어할 수 있고 에너지를 통해 원하는 곳에 주입이 가능합니다.
Ion Implantation은 Diffusion 방법론과 달리 Solid Solubility(불순물이 주입될 수 있는 한계)에 제한을 받지 않아
고농도부터 저농도까지 농도를 조절하여 Doping을 진행할 수 있다는 장점이 존재합니다.
우리는 이를 통해 Threshold Voltage를 조절하거나 Gettering을 통해 Defect를 모을 수도 있고
Gate가 통제하기 어려운 부분들을 막을 수도 있습니다.
Ion Implantation 장비

위 그림은 Ion Implantation의 장비를 보여주는데요, 하나하나 분해해서 살펴보도록 하겠습니다.
1) 진공장치

먼저 전체적으로 장비는 진공상태여야합니다.
만약 진공상태가 아닌 경우, 이온 상태의 불순물이 내부 기체 분자와 충돌하여
웨이퍼에 효과적인 주입이 어렵기 때문에 Pump를 통해 고진공 상태로 만들어주는 것이 중요합니다.
2) 이온공급장치


이온공급부란 넣고자 하는 불순물을 이온상태로 만들어주는 부분인데요,
먼저 필라멘트에 전압을 가해 전류를 흐려주게 되면 열 에너지가 발생하게 되고
전자는 그러한 필라멘트로부터 가속을 받게 됩니다.
그 후, 전자는 불순물 가스들과 충돌함으로써 불순물 이온이 생성되고
전기장에 의해 바깥으로 밀려나면서 불순물 이온이 주입되게 되는 원리입니다.
3) 분류기


쉽게 말해 분류기는 원하는 종류의 불순물 이온만 골라내는 부분입니다.
앞선 이온 공급장치(Ion Source)를 통해 튀어나온 이온은 Charge를 띄며
이러한 이온의 이동방향에 수직하게 자기장을 걸어주면 자기장과 수직한 방향으로 힘이 발생하여 휘어지게 됩니다.
즉, 필요한 이온에 적합한 자기장을 구한 다음 수직으로 걸어줌으로써 골라내게 되는 것입니다.

위 이론을 수식으로 나타내면 이와 같으며
여기서 V와 R은 이미 정해진 변수이니 우리는 분류하고자 하는 이온의 M과 q만 고려하여 분류하게 되면 됩니다.
4) 가속기

가속기란 원하는 깊이에 불순물을 넣어주고자 불순물 이온에 적절한 에너지를 가해주는 부분으로
주입하고자 하는 웨이퍼 깊이에 적합한 전압을 이온에 가해주면되는 원리입니다.
5) 집속기

집속기란 빛을 렌즈에 Focusing 해주는 원리처럼 이온에 초점을 가해
원하는 위치에 원하는 양을 넣고자 하는 부분으로 이온에 전기/자기장을 가함으로써 작동됩니다.
만약 이온이 퍼져 있는 상태로 웨이퍼에 주입되게 되면 원하는 양만큼 주입하기 힘들기 때문에 집속기가 필요합니다.
6) 중성빔 포획 장치

Ion Implantation 장비는 완벽한 진공이 아니기 때문에 불순물 이온이 이동하다보면 기체 분자와 충돌하게 되는데,
불순물 중 제대로 이온화되지 않고 중성적인 상태로 남아있는 것을 걸러내는 부분을
중성빔 포획장치라고 정의합니다.

중성빔 포획 장치가 필요한 이유가 무엇일까요 ?
예를들어 인 이온이 장비 속 질소와 부딪혀 중성자가 발생한다고 가정해봅시다.
우리는 이온 빔을 통해 웨이퍼 주위를 Scan 하며 원하는 위치에 고르게 불순물을 주입하는 것이 목표인데
이러한 중성자는 반응이 없어 고르게 분포하기 어려우므로 Doping 시 Uniformity에 치명적인 영향을 미칩니다.
그렇기 때문에 해당 장치가 필요한 것입니다 !
7) 주사기

주사기는 전기/자기장을 통해 이온 빔을 제어해주는 부분입니다.
| i) X-Y 주사법 - 전기/자기장을 통해 Scanner 빔(이온 빔)을 x, y축으로 움직이며 주입하는 방법 ii) 기계적 주사법 - Scanner 빔(이온 빔)은 고정시켜놓고 웨이퍼가 올라가있는 Stage만을 움직이며 고르게 주입하는 방법 iii) 혼합 주사법 - Scanner 빔(이온 빔)과 웨이퍼 모두 움직여주는 방법 |
8) 웨이퍼 가공실

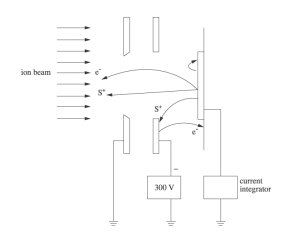
최종적으로 불순물 이온은 원하는 깊이와 양대로 웨이퍼에 주입되게 됩니다.
하지만 공정 종류에 따라 이온주입의 시간과 고려해야하는 사항이 다른데요,
만약 넣고자 하는 이온의 양이 적은 경우엔
이온 주입의 시간이 적지만 고진공 상태로 만들기 위해 집중해야합니다. (Throughtput)
반대로 넣고자 하는 이온의 양이 많은 경우엔 이온 주입 시간이 많다는 차이점이 존재합니다. (High Current Implanter)
또한, 웨이퍼 위에 Faraday 컵이라는 것을 설치하기도 합니다.
이온 빔이 웨이퍼를 때렸을 때 때린 불순물 및 전자가 반사되어 튀어나오기도 하는데요,
만약 이것을 그냥 놔두면 불순물 주입 시 방해가 되기 때문에
이를 방지하고자 튕겨져 나오는 이온을 포획하는 Faraday 컵이 필요하게 되는 것입니다.
Ion Implantation의 특징
넓은 범위의 Dose
앞선 글에서 알아보았던 Diffusion(확산)의 경우,
적은 양을 주입하면 웨이퍼에 따라 산포가 달라져 고르게 Doping 시키기 어려운 데다가
Solid Solubility 때문에 많은 양을 주입하는 것도 어렵습니다.
반면, Ion Implantation(이온주입)의 경우 Diffusion에 비해 단위면적 당 넣을 수 있는 이온의 양,
즉 Dose의 범위가 넓다는 장점이 있습니다.
유연한 Profile 조절
또한, 주입하고 싶은 깊이를 원하는대로 조절할 수 있다는 장점이 있습니다.
구체적으로 말씀드리자면 Diffusion 공정에 비해 상대적으로
표면에서 수직으로 들어가는 깊이를 조절하기 쉬운 공정이라고 할 수 있습니다.
이때, 에너지를 사용하는데 적은 에너지를 가하면 얕게 주입되고, 많은 에너지를 가하면 깊게 주입되게 됩니다.


하지만 아무리 Ion Implantation을 진행한다 하더라도
충돌에 의해 멈추는 경로가 이온마다 차이가 있기 때문에 완벽하게 그 위치에만 집중되기 어려운데요
따라서 Ion Implantation의 Profile은 Gaussian 분포를 따른다고 말할 수 있습니다.
더 풀어 말해보자면 Ion Implantation을 진행할 시 이온이 주입되는 위치는
확률적으로 평균적인 깊이(Rp)에 존재하게 되고 산포(ΔRp) 또한 존재한다는 얘기겠지요.
저온 공정 진행 가능
Ion Implantation 공정은 Diffusion 공정에 비해 상온에서 공정이 가능하다는 장점이 있습니다.
상온 공정이 가능해지면 좋은 점이 무엇일까요 ?
Ion Implantation 공정에서는 Mask로 PR(Photo Resist, 감광막)을 쓰는 편인데,
이러한 PR은 다른 Mask 재료에 비해 Photo 공정만 거치면 된다는 장점이 존재합니다.
하지만 PR의 경우 열에 약하기 때문에 상대적으로 고온에서 진행하는 Diffusion에서는 사용이 불가하지만
Ion Implantation 공정의 경우 상온 공정이 가능하므로 PR 사용이 가능하다는 것이 장점이라고 할 수 있겠습니다.
적게 발생하는 측면 퍼짐의 현상

왼쪽은 Ion Implantation 공정 과정이고 오른쪽은 Diffusion 공정 과정인데요,
그림에서도 알 수 있다시피 Diffusion 공정과 달리 Ion Implantation은
옆으로 퍼지는 것이 상대적으로 적어 미세 공정에 유리하다는 장점이 존재합니다.
주입된 이온의 분포


앞서 말했다시피 Ion Implantation 공정을 진행하게 되면
충돌에 의해 멈추는 경로가 이온마다 차이가 있기 때문에 Profile이 위와 같은 Gaussian 분포를 따른다고 하였습니다.
이때, 비정질 일 때 주입된 이온의 분포와 단결정 일 때 주입된 이온의 분포를 비교하여 알아보겠습니다.
비정질 상태의 Target
비정질(Amorphous)은 말그대로 원자들이 규칙적으로 정렬되어있지 않은 고체를 의미합니다.
이러한 비정질 상태의 Target에 이온을 주입하게 되면 어떻게 될까요 ?
예를 들어 As 이온에 Energy를 가함으로써 비정질 상태의 Target(Si 웨이퍼)을 때린다고 가정할 때,
보통 아래와 같이 3가지 반응이 나타납니다.
| i) Implantation : As+으로 Si 웨이퍼에 주입 ii) Reflection : As+이 다시 반사 iii) Sputtering : Energy를 전달받아서 본래의 Target(Si)이 튀어나오는 형태 |
우리는 일단 이 3가지 반응 중에서 Implantation에 초점을 두어 알아보겠습니다.

위에서도 말씀드렸다시피 이온이 웨이퍼에 주입되면
표면에서부터 이온이 들어간 거리를 R로서 정의할 수 있고
표면에서 수직방향으로의 깊이를 Rp로 정의할 수 있는데
이는 모두 에너지를 통해 조절을 할 수 있다고 말씀드렸습니다.
Ion Implantation 공정에서 가장 중요한 점은 우리가 원하는 위치에 이온을 주입해야한다는 것인데
이때 이온이 얼마만큼 이동할 수 있는지, 즉 R을 알아야합니다.

이를 위해 우리는 에너지 손실 방정식을 사용하게 됩니다.

이온이 주입되었을 때 이동하는 거리는 에너지를 잃고 멈춘다는 의미와 동일하기 때문에
앞선 에너지 손실 방정식을 x에 대해 적분함으로써 R(주입된 이온의 이동거리)을 구할 수 있습니다.
보통 이온은 Target에 주입되었을 때 원자에 있는 전자와 이온간의 상호작용,
원자에 있는 핵과 이온간의 상호작용에 의해 에너지가 손실됩니다.
따라서 충돌한 이온 에너지의 손실은
Target의 원자핵과 전자의 Stopping Power과 비례하며
Target 이온(Si)의 원자 농도가 높을수록 에너지 손실이 큽니다.

위 그래프에서도 알 수 있다시피 이온주입을 할 때 주입한 에너지에 따라 깊이가 달라지고
불순물의 무게에 따라 불순물 이온이 멈추는 위치가 다릅니다.
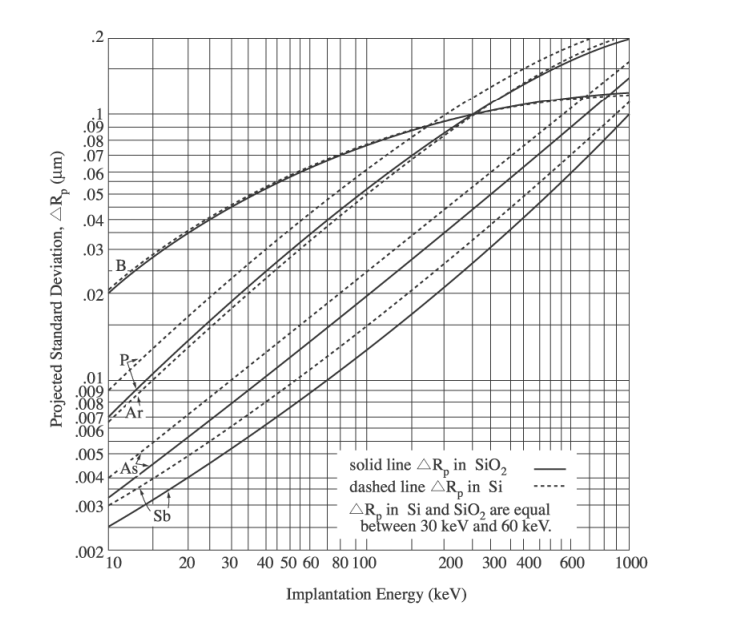
뿐만아니라 불순물마다 에너지를 세게 때릴수록 불순물 간의 표준편차가 증가합니다.
따라서 우리는 Ion Implantation 공정을 진행할 때
이러한 점들을 고려해서 이온을 원하는 위치에 주입하는 것이 목표겠지요 ?
단결정 상태의 Target

사실 대부분의 웨이퍼에서는 Si 원자들이 앞서 알아봤던 비정질 상태이기 보다는 결정방향이 있는 단결정 상태이며
이러한 상태에서 이온을 주입하게 되는데요,
이때 Channeling이 발생할 수 있다는 문제점이 존재합니다.
여기서 Channeling이란 표면에서 Si 원자들이 단결정 상태로 잘 정렬되어있을 때
불순물 이온을 수직으로 때리면 어떤 이온들은 Si 이온들과 충돌하지만
어떤 이온들은 결정구조 사이로 들어와 더 깊은 곳까지 통과하게 됨을 의미합니다.
만약 이러한 Channeling 현상이 발생하면 우리가 원하는 위치에 주입되긴 어렵다고 말할 수 있습니다.
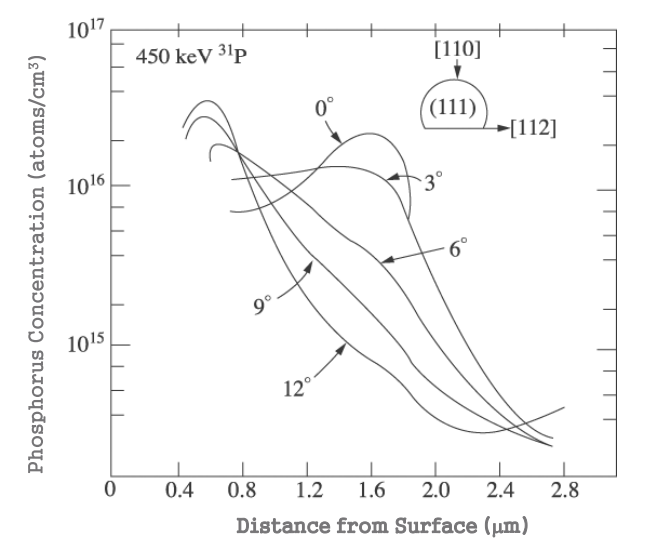
따라서 이러한 문제를 해결하기 위해 불순물 이온을 수직으로 때리기 보다는
기울여서 때림으로써 해당 문제를 해결하는 편입니다.
위 그래프에서도 볼 수 있다시피 수직으로 주입하면 상당히 깊이 들어가며 분포도 상대적으로 커지는데
각도를 기울일수록 비정질 상태에서 주입하는 것과 가까워지므로 깊이도 얕아지고 산포도 줄어듦을 알 수 있습니다.
손상과 Annealing
비교적 상온에서 진행하는 Ion Implantation 공정에서도 열을 활용하는 Annealing 과정을 거쳐야합니다.
에너지를 통해 이온을 Target에 주입함으로써 손상이 발생하기 때문인데요
이러한 손상을 회복하기 위해서도 필요하며
그냥 때려서 넣으면 불순물들이 Target 안에서 아무 위치에서나 존재하기 때문에
불순물들을 제대로 활성화시키기 위해서 해당 과정이 필요합니다.

먼저, 손상은 위와 같은 원리에 의해 발생하는데요

즉, 이온 주입 에너지가 충분히 높으면 이온들이 연쇄적으로 충돌을 일으켜 Cluster 형태로 결정구조가 파괴됩니다.
가벼운 이온이 만드는 손상 (ex. B, P)
손상은 이온의 구조에 따라 손상 정도가 다릅니다.
앞서 말씀드렸다시피 이온은 같은 에너지를 줘서 웨이퍼 안에 주입시켰을 때,
이러한 불순물 이온을 멈추게 하는 Stopping Power가 아래와 같이 총 2개인데요
| i) Se : 원자 핵 주위를 돌고 있는 Electron과의 상호작용 ii) Sn : 원자 핵과의 상호작용 |

가벼운 이온의 경우엔 Se에도 쉽게 영향을 받기 때문에
Se보다 Sn에 대한 영향이 커서 불순물 이온들이 상대적으로 Si를 파괴하지 않는 것을 알 수 있습니다.
무거운 이온이 만드는 손상 (ex. As)
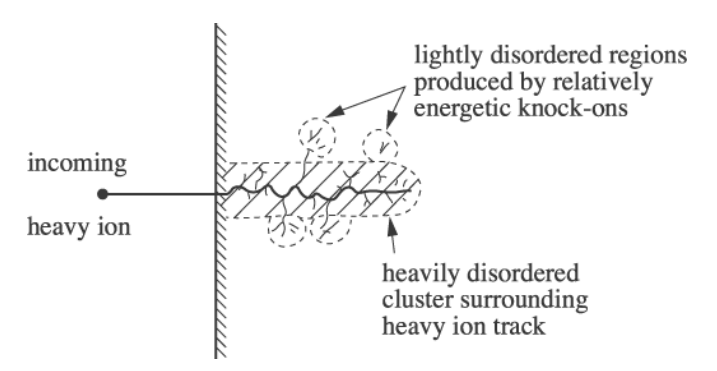
하지만 무거운 이온의 경우엔 Se 만으로는 멈추기 힘들어
다수의 이온들이 위치를 벗어나면서 Si 결정을 파괴한다고 볼 수 있습니다.
따라서 무거운 이온을 주입시킬수록 Annealing을 통해 회복시켜주는 것이 필요합니다.
Annealing

앞에서도 알아봤다시피 Annealing의 목적은 손상 회복과 불순물 활성화인데요,
Annealing을 통해 얼마나 효과적으로 해당 문제들이 해결되는지 그래프를 통해 알아보도록 하겠습니다.
| 목적 1) 망가진 결정 구조를 원래의 단결정 상태로 회복시키기 위해 열 가하기 |

결정 구조가 파괴된 것들은 Si 웨이퍼에서 결함이 되기 때문에
Mobility가 떨어져 전류 Quality가 나빠질 수도 있고
결함으로 State가 발생하게 되면 원치 않는 Electron-Hole이 발생하여 Leakage Current가 발생할 수 있습니다.
따라서 Mobility와 Leakage Current 개선을 위해서는 Annealing 과정이 필요하게 됩니다.
| 목적 2) 불순물을 활성화시키기 위해 열 가하기 |

보통 Ion Implantation 공정이 끝나면 불순물들이 아무 위치에나 존재하게 되는데,
이러한 랜덤 상태로는 Electron-Hole Pair를 효과적으로 만들기 어렵습니다.
따라서 Annealing을 통해 주입된 이온들을 활성화시킴으로써 불순물 이온이 Si를 대체하는 위치에 들어가도록 만들어줘야
Doping을 해준만큼 활성화된 Carrier Concentration을 얻을 수 있게됩니다.
Diffusion vs Ion Implantation
지금까지 우리는 반도체 공정에 있어 Doping에 대해서도 알아보았고,
다양한 Doping 방식 중 Diffusion과 Ion Implantation에 대해 알아보았습니다.
그럼 각 방법에 대한 장단점을 살펴보자면
| 장점 | |
| Ion Implantation | Diffusion |
| - 상온에서 Mask를 쓸 수 있음 (PR 사용 가능) - Dose (단위면적 당 들어가는 불순물의 양) 조절 가능 - E-field 세기를 통해 깊이 조절 가능 |
- Damage(격자 구조 손상)가 발생하지 않음 - 한 번에 여러 장 (Batch Fabrication) 공정 가능 * Batch = 웨이퍼 한 카세트 (25장) |
| 단점 | |
| Ion Implantatin | Diffusion |
| - Damage(격자 구조 손상) 발생 - Damage로 인한 Junction Leakage 발생 - 한 번에 여러 장 진행하는 것이 불가능 - Channeling 발생 |
- 물질마다 Solid Solubility가 달라 고농도 주입 불가능 - Chamber안에 확산 시키는 형태이므로 저농도 주입 불가능 |
최근엔 반도체 소자 사이즈가 점차 줄어들면서 정교한 작업이 필요하게 되어 이온주입을 많이 쓰는 추세입니다.
다음 글에서는 반도체 위에 원하는 물질을 얇게 까는 Deposion(증착) 공정에 대해 알아보도록 하겠습니다.
